近日,日本沖繩科學技術大學(OIST)的Tsumoru Shintake教授帶領的研究團隊提出了一項全新、大幅簡化的面向極紫外(EUV)光刻機的雙反射鏡系統。相比傳統的至少需要六面反射鏡的配置,新的光學投影系統僅使用了兩面反射鏡,在確保系統維持較高的光學性能的同時,能讓EUV光線以超過初始值10%的功率到達晶圓,相比傳統系統中僅1%的功率來說,提了高到了原來的10倍,可說是一大突破。
換句話來說,全新的光學系統相對原有的系統來說,功耗可以降低到原來1/10!而對于EUV光刻機來說,隨著對于光源系統功率要求的大幅降低,將使得其整套光源系統的體積和成本也將大大的降低,反射鏡數量的減少也將帶來成本降低,同時光刻機能耗的降低也將使得其運行的電耗成本極大的降低,并顯著提設備的可靠性和使用壽命。
ASML EUV光刻機的光源與投影系統解析
目前ASML是全球唯一的EUV光刻機供應商,其先進的EUV光刻機擁有超過10萬個零件,涉及到上游5000多家供應商。這些零部件極為復雜,對誤差和穩定性的要求極高,并且這些零件幾乎都是定制的,90%零件都采用的是世界上最先進技術,85%的零部件是和供應鏈共同研發,甚至一些接口都要工程師用高精度機械進行打磨,尺寸調整次數更可能高達百萬次以上。這也使得一臺EUV光刻機的售價高達1.5億美元左右。
從EUV光刻機的結構來看,其內部主要由“照明光學模組”(Illuminator)、“投影光學模組”(Projection optics)、“光罩傳輸模組”(Reticle Handler)、“光罩平臺模組”(Reticle Stage)、“晶圓傳送模組”(Wafer Handler)、“晶圓平臺模組”(Wafer Stage)及“光源模組”(Soure)這七大模組組成。

△ASML EUV光刻機七大模塊
其中,“照明光學模組”是EUV最核心的作業模組。這里EUV光線由“光源模組”(Source)生成后,導入“照明光學模組”。過程還必須進行檢測與控制光的能量、均勻度及形狀。之后再將EUV光線通過“投影光學模組”傳輸穿過光罩(掩膜版),再由聚光鏡(Project Lens)將影像聚焦成像在晶圓表面的光阻層。
EUV的光源分為兩個部分:第一個部分就是通快集團供應的30KW二氧化碳激光器,也稱之為“drive laser”,其主要作用就是提供10600nm波長的高功率激光,用來照射錫(Sn)金屬液滴,以產生13.5nm波長的EUV光線。

△通快激光放大器的核心組件——高功率種子模塊 (HPSM)。根據官網資料顯示,通快集團向ASML供應的二氧化碳激光器擁有457,329個部件,系統內的線纜長度高達7,322米,重量更是達到了17,090千克。
第二部分則是Cymer的工作,其主要承擔提供并控制錫金屬液滴以每秒50000滴的速度從噴嘴內噴出,并利用通快集團的30KW二氧化碳激光器對每滴錫金屬液滴每秒進行兩次轟擊(即每秒需要10萬個激光脈沖),從而產生穩定的13.5nm波長的EUV,然后對光線進行收集,并通過反射鏡修正光的前進方向。

△ASML與德國光學公司蔡司(Zeiss)合作,由該蔡司來生產反射鏡,以使得EUV光線經過多次反射后能夠精準的投射到晶圓上。
由于EUV光線波長非常短,所以它們會很容易被空氣吸收,所以整個EUV光源的工作環境需要被抽成真空。同時,EUV光線也無法被玻璃透鏡折射,必須以硅與鉬制成的特殊鍍膜反射鏡,來修正光的前進方向,而且每一次反射可能將會損失約30%能量,而EUV光學照明系統當中有6組反射鏡,導致最終到達晶圓光阻層的EUV光子理論上只有原來的約1%左右。
據芯智訊向ASML內部人士了解到,目前ASML EUV光刻機的EUV光源功率已經提高到了500W(主要依賴于光源優化,drive laser依然是30kW),也就是說其最終作用到晶圓光阻層的功率僅為5W,這相比多年前的250W光源功率所帶來的最終工作功率提升了一倍,這也提升了其EUV光刻機的每小時處理晶圓數量的能力。
日本沖繩科學技術大學全新光學投影系統
日本沖繩科學技術大學的Tsumoru Shintake教授在論文中也指出,在傳統的光學系統中,如照相機、望遠鏡和傳統的紫外光刻技術,孔徑和透鏡等光學元件軸對稱(對稱于中心軸)排列在一條直線上。這種配置確保了最高的光學性能,具有最小的光學像差,從而實現高質量的圖像。然而,這不適用于 EUV光線,因為它們的波長極短,會被大多數材料吸收,這意味著它們不能穿過透明鏡片。出于這個原因,EUV 光使用新月形鏡子進行定向,這些鏡子以鋸齒形圖案在開放空間中沿光路反射光線(見下圖)。然而,由于這種方法會導致光線偏離中心軸,因此它犧牲了重要的光學特性并降低了系統的整體性能。
而Tsumoru Shintake教授提出的面向EUV光學系統的雙反射鏡解決方案,相比原本的六個反射鏡的方案,能讓光源效率提升到原來(標準值為1%)的10倍,即EUV光線能夠以超過初始值10%的功率到達晶圓光阻層。如果維持原有的作用到晶圓光阻層的EUV光線功率不變,那么采用新方案后,EUV光源的初始功率則可以降低到原來的1/10,這也將使得整個EUV光刻機的光學系統更簡化、更高效、可靠性更高、更低成本。
Tsumoru Shintake教授在論文摘要中介紹稱,如果以每小時 100 片晶圓的處理速度計算,如果采用全新的雙反射鏡系統,將可使得所需的 EUV 光源功率降低至 20 瓦。全新設計的投影物鏡可實現 0.2 NA(20 毫米領域)和 0.3 NA(10 毫米領域),可組裝成類似于 DUV 投影物鏡系統的圓柱型裝置,具有出色的機械穩定性,且更易于組裝/維護。EUV通過位于衍射錐兩側的兩個窄圓柱形反射鏡引入掩膜版前方,提供平均法向照明,減少光刻掩膜三維效應。簡化的照明系統提供對稱的四極離軸照明,繞過了中心遮蔽,提高了空間分辨率,還實現了柯勒照明。理論分辨率極限為 24nm(20mm視場),圖像縮小系數 ×5,物像距離 (OID) 2000 毫米。使用曲面掩模后,物像距離高度可降低到(OID)1500mm,分辨率為 16nm(10mm視場)。它將適用于移動終端應用的小尺寸芯片生產以及最新的chiplet芯片技術。
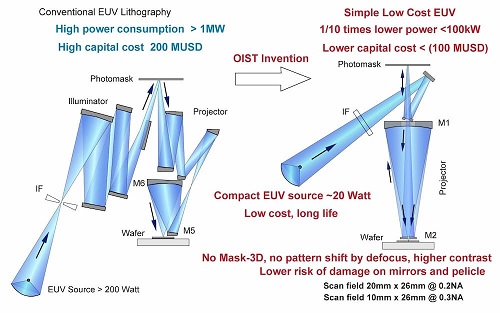
△左邊是目前使用的行業標準模型。右邊是Tsumoru Shintake教授的模型。這項創新技術具有顯著更好的穩定性和可維護性,因為它簡化了設計,只有兩個鏡子,只需要20W的光源,從而將系統的總功耗降低到100kW以下,與通常需要1MW(=1,000kW,經與ASML內部人士確認,現有的EUV光刻機系統沒有這么高的功耗)以上的傳統技術相比,功耗降低了90%。并且新系統保留了非常高的對比度,同時還減少了掩模3D效應,實現了將邏輯圖案從光掩模準確轉移到硅晶圓所需的納米精度。
EUV光刻技術的核心是將光掩模圖像轉移到硅晶圓上的投影儀,它僅由兩個反射鏡組成,就像天文望遠鏡一樣。“考慮到傳統EUV光刻至少需要六個反射鏡,我們的雙反射鏡配置非常簡單。這是通過仔細重新思考光學像差校正理論而實現的。這是經典物理學在量子物理學之前的勝利。”Shintake教授解釋說:“該性能已使用光學模擬軟件(OpTaliX)進行了驗證,并保證足以用于生產先進半導體。”
不過,新的雙反射鏡光學系統的挑戰在于,防止光學像位差,并確保高效率的光傳輸。對此,需將這些鏡子對齊成一條直線,確保系統維持較高的光學性能,不會出現與EUV光線相關的扭曲現象。為了解決這些問題,Tsumoru Shintake教授通過將兩個軸對稱鏡與一條直線上的微小中心孔對準,實現了其卓越的光學性能。
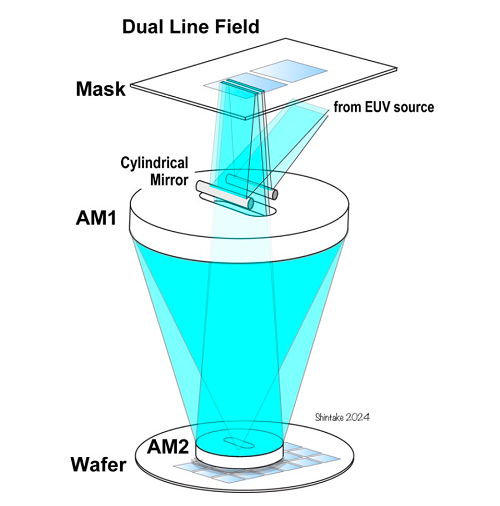
△為了避開中心遮擋并提高空間分辨率,EUV 光通過位于衍射光錐兩側的兩個窄圓柱形反射鏡引入掩膜前方。這提供了均勻化照明光場,減少了掩膜三維效應。簡化的照明系統提供了對稱的四極離軸照明,繞過了中心遮擋,提高了空間分辨率,還實現了柯勒照明。為避免圓柱鏡的阻擋衍射,Tsumoru Shintake教授引入了通過設計一種新的照明光學方法解決了這個問題,該方法被稱為“雙線場”。該方法在不干擾光路的情況下,用EUV光從正面照射平面鏡面的光罩。
Tsumoru Shintake教授解釋說:“如果你拿著兩個手電筒,每只手拿著一個手電筒,并將它們以相同的角度對準你面前的鏡子,那么一個手電筒的光線總是會照射到對面的手電筒上,這在光刻中是不可接受的。但是,如果你在不改變手電筒的角度的情況下向外移動手,直到中間從兩側完全照亮,光線就可以被反射而不會與對面手電筒的光線碰撞。由于兩個光源對稱放置并以相同角度照亮光罩,因此平均而言,光罩是從正面照亮的。這也最大限度地減少了掩膜三維效應。這就像哥倫布的蛋,”“因為乍一看似乎不可能,但一旦解決了,它就變得非常簡單。”

據介紹,目前日本沖繩科學技術大學已經就該技術提交了專利申請,并有望通過示范實驗投入實際應用。“全球EUV光刻市場預計將從2024年的89億美元增長到2030年的174億美元,年均增長率約為12%。這項專利有可能產生巨大的經濟效益。”Tsumoru Shintake教授總結道。
日本沖繩科學技術大學執行副總裁兼 OIST 創新負責人 Gil Granot-Mayer 表示:“OIST 致力于創造能夠影響人類的尖端科學。這項創新體現了OIST的精神,即探索不可能的事情并提供原創的解決方案。盡管我們在開發這項技術方面還有很長的路要走,但我們致力于這樣做。我們希望這項來自沖繩的技術將對半導體行業產生變革性影響,并幫助解決能源消耗和脫碳等全球問題。
小結:
如果Tsumoru Shintake教授的面向EUV光刻的雙反射鏡系統解決方案能夠商用,將有望幫助現有的EUV光刻機的EUV光源系統的功率降低90%。比如現在ASML EUV光刻機的EUV光源功率為500W,那么采用新的接近方案后,只需要50W的EUV光源即可達到現有的作用于晶圓的EUV光線的功率要求。這也意味著為了產生足夠高功率EUV光源的“drive laser”也就無需功率高達30KW二氧化碳激光器,這將極大的降低光源系統的功耗,同樣配套的散熱、冷卻水需求也將會大幅降低。
而且,該解決方案還能夠使得目前EUV光刻機的“照明光學模組”和“投影光學模組”更為簡化,不僅所需的零部件數量更少(反射鏡減少、二氧化碳激光器要求降低、配套散熱系統要求降低),體積和重量也將會更小。比如前面提到的,通快集團向ASML EUV光刻機供應的30KW二氧化碳激光器,光零部件就有457,329個,重量更是達到了17,090千克,如果采用功率更低的二氧化碳激光器,無疑將會大幅降低零部件的數量、體積與重量。
總結來看,新的解決方案如果能夠商用,不僅可以大幅降低EUV光刻機的功耗和綜合成本,同時隨著整個系統的復雜度的降低,穩定性將得到提升,制造難度和制造流程也都有望縮短。零部件減少和光源系統的簡化也將使得整體的體積和重量大幅減少,這也將使得EUV光刻機的發貨、運輸及安裝更為簡便。
當然,目前Tsumoru Shintake教授提出的這項技術方案還是處于理論研究階段,不過其確實有計劃通過示范實驗投入實際應用,但最終能否成功商用依然是未知之數。


