01
封測簡介及技術發展歷程
1.封測介紹
半導體封測是在晶圓設計、制造完成之后,對測試合格的晶圓進行封裝檢測得到獨立芯片的過程。封測包含封裝和測試兩個環節。從價值占比看,集成電路封裝環節價值占比約為80%-85%,測試環節價值占比約為15%-20%。
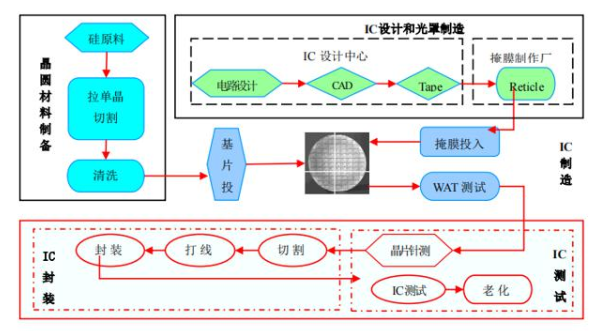
在半導體產業鏈的設計和制造這兩個環節中國都處于劣勢,畢竟技術和資金壁壘高,先發優勢明顯,而封測的附加價值相對低,勞動密集度高,相應的進入壁壘就低,因此封測是國產化最高的環節。
2.封測技術發展歷程
根據《中國半導體封裝業的發展》,迄今為止全球集成電路封測行業可分為五個發展階段,自第三階段起的封裝技術統稱為先進封裝技術。
當前,中國封裝企業大多以第一、第二階段的傳統封裝技術為主,例如DiP、SOP等,產品定位中低端;全球封裝業的主流技術術處于以CSP、BGA為主的第三階段,并向以系統級封裝(SiP)、倒裝焊封裝(FC)、芯片上制作凸點(Bumping)為代表的第四階段和第五階段封裝技術邁進。先進封裝技術更迎合集成電路微小化、復雜化和集成化的發展趨勢,是封測產業未來的發展方向。

半導體行業的發展遵循著摩爾定律,先進制程每兩年更新一代,隨著摩爾定律極限的逼近,工藝突破難度加大,各大廠商為追求低成本,高性能,將突破點聚焦在封測技術上,先進封測技術取代趨勢顯著。
02
半導體封測市場概況
2021年,我國集成電路產業銷售額達到10458億元,同比增長18%。其中,設計業銷售額4519億,同比增長19%;制造業銷售額3176億元,同比增長24%;封測業銷售額2763億元,同比增長10%。2019-2021年,封測規模的年復合增長率為8%。2021年前三季度,我國半導體自給率52%,距離國務院制定的“2025年芯片自給率達到70%”的目標還有較大空間。

按是否焊線,封裝工藝分為傳統封裝與先進封裝。
傳統封裝靠金屬線實現芯片與外部電子元器件的電氣連接,但密度太高會導致短路,所以封裝面積與芯片面積比值較大。
先進封裝采用其他非金屬線的方式進行連接,種類有很多,比如3D方式通過堆疊而非平面封裝,縮小了封裝面積與芯片面積的比值,并使單個封裝里集成的元器件數量更多。提升了芯片的集成度,更適用于多元化的下游應用場景的需求。
與傳統封裝相比,先進封裝可以提升芯片的功能密度,縮短互聯長度從而優化整體性能和功耗水平,實現系統級封裝。
2019-2015年,相比同期整體封裝市場(CAGR=5%)和傳統封裝市場,全球先進封裝市場CAGR約8%,增長更為顯著,將成為全球封裝市場的主要增量。國內封測廠商技術水平基本與海外同步,2020年中國大陸先進封裝產值占全球比例從2015年的10.3%提升至2020年的14.8%。

03
封測行業競爭情況
按照技術儲備、產品線、先進封裝收入占比等指標,可將國內集成電路企業大致分為三個梯隊:
第一梯隊:已實現了BGA、LGA和CSP穩定量產,具備部分或全部第四階段封裝技術量產能力,同時在第五階段晶圓級封裝領域進行技術儲備或產業布局,國內企業以長電科技、通富微電和華天科技為代表。
第二梯隊:公司產品以第一、二階段為主,并具備第三階段技術儲備,這類企業大多為國內區域性封測領先企業。
第三梯隊:公司產品主要為第一階段通孔插裝型封裝,少量生產第二階段表面貼裝型封裝產品,這類企業以眾多小規模封測企業為主。

集成電路封測為我國集成電路領域最具競爭力環節,共有三家企業營收位列全球前十。
在集成電路設計和制造環節,我國和世界頂尖水平差距較大,特別是在制造領域最為薄弱,而封測環節則為我國集成電路三大領域最為強勢的環節。
2021年全球營收前十大封測廠商排名中,有三家企業位于中國大陸,分別為長電科技、通富微電和華天科技。

我國A股中有多家上市公司處于半導體封測領域,包括長電科技、華天科技、通富微電、晶方科技、環旭電子等典型公司,其中晶方科技、環旭電子在部分封裝領域優勢明顯。國內封測前三廠商不斷擴大規模,相繼進行并購,長電科技并購星科金朋、華天科技并購Unisem、通富微電并購AMD封測廠。

04
總結
在集成電路設計和制造環節,我國和世界頂尖水平差距較大,特別是在制造領域最為薄弱,而封測環節則為我國集成電路三大領域最為強勢的環節。大家可以關注一下先進封裝的相關公司,后續會對其進行詳細的介紹。
更多信息可以來這里獲取==>>電子技術應用-AET<<


