芯天下封裝背景
隨著芯片封裝技術的發展,半導體封裝經歷了從DIP、SOP等引腳插入式封裝到DFN、BGA等表面貼片封裝再到WLCSP等晶片級封裝的變革;同時隨著智能穿戴等消費類電子產品的飛速發展,芯片封裝技術面臨著“集成度高、小型化、連接工藝升級”的挑戰和機遇。
芯天下在面對市場機遇時適時推出了業內超小的DFN封裝(1.2*1.2*0.4mm),同時在適配更先進封裝技術的探索上未停下腳步。隨著業內WLCSP封裝技術的不斷成熟,芯天下在2020年開始導入WLCSP的封裝并已通過全面考核,于2021年Q1季度正式推出1.8V 64Mb &128Mb的WLCSP封裝,后續會陸續推出全系列容量的WLCSP封裝滿足客戶需求。
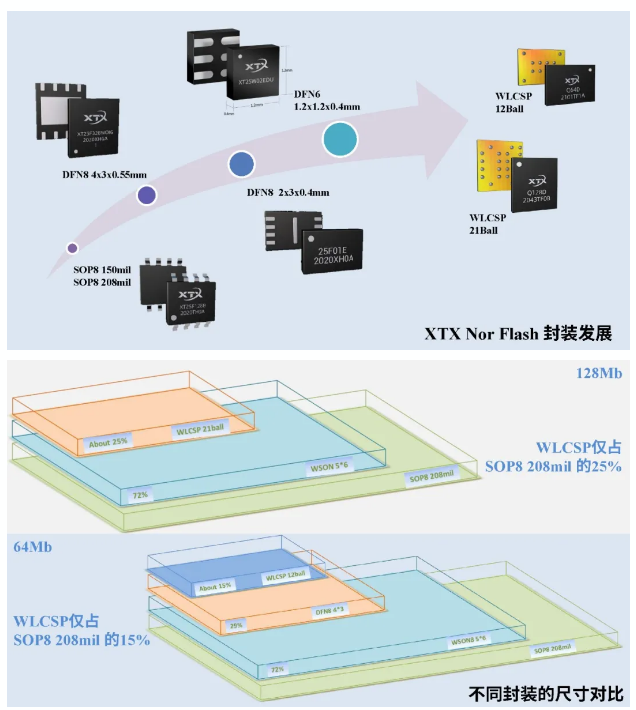
芯天下WLCSP Roadmap

芯天下WLCSP 產品特點
Wafer Level Chip Scale Packaging是晶片級芯片封裝,是集成電路可實現的最小尺寸封裝,其優點有:
(1)外尺寸小:封裝后的投影面積等同裸晶片的尺寸,做到封裝尺寸和晶片尺寸1:1;
(2)電性能佳:相比傳統打線,WLCSP內部引線短,信號完整性大幅度提高;
(3)可靠性好:無框架、注塑等引入的分層問題,散熱性好。同時能夠滿足JEDEC MSL-1(Moisture Sensitivity Level-1)要求;
(4)兼容性強:兼容WLCSP業界標準封裝,硬件上PIN TO PIN替換。

應用實例
WLCSP的應用領域非常廣泛,主要涉及智能穿戴,包括智能手表,手環,頭戴式設備,TWS等市場,例如:
1.智能眼鏡
2.TWS耳機
3.智能心率手環
本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

