IC封裝技術的發展歷程和水平代表了整個封裝技術(包括MEMS封裝和光電子器件封裝)的發展歷程及水平。
目前在MEMS封裝中比較常用的封裝形式有無引線陶瓷芯片載體封裝(LCCC-Leadless Ceramic Chip Carrier)、金屬封裝、金屬陶瓷封裝等,在IC封裝中倍受青睞的球柵陣列封裝(BGA-Ball Grid Array)、倒裝芯片技術(FCT-Flip Chip Technology)、芯片尺寸封裝(CSP-Chip Size Package)和多芯片模塊封裝(MCM-Multi-Chip Module)已經逐漸成為MEMS封裝中的主流。
BGA封裝的主要優點是它采用了面陣列端子封裝、使它與QFP(四邊扁平封裝)相比,在相同端子情況下,增加了端子間距(1.00mm,1.27mm,1.50mm),大大改善了組裝性能,才使它得以發展和推廣應用。
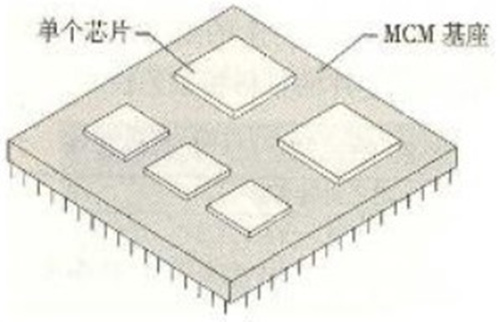
21世紀BGA將成為電路組件的主流基礎結構。
從某種意義上講,FCT是一種芯片級互連技術(其它互連技術還有引線鍵合、載帶自動鍵合),但是它由于具有高性能、高I/O數和低成本的特點,特別是其作為“裸芯片”的優勢,已經廣泛應用于各種MEMS封裝中。
CSP的英文含義是封裝尺寸與裸芯片相同或封裝尺寸比裸芯片稍大。日本電子工業協會對CSP規定是芯片面積與封裝尺寸面積之比大于80%。
CSP與BGA結構基本一樣,只是錫球直徑和球中心距縮小了、更薄了,這樣在相同封裝尺寸時可有更多的I/O數,使組裝密度進一步提高,可以說CSP是縮小了的BGA。
在MCM封裝中最常用的兩種方法是高密度互連(High Density Interconnect簡稱HDI)和微芯片模塊D型(Micro Chip Module D簡稱MCM-D)封裝技術。
高密度互連(HDI)MEMS封裝的特點是把芯片埋進襯底的空腔內,在芯片上部做出薄膜互連結構。
而微模塊系統MCM-D封裝是比較傳統的封裝形式,它的芯片位于襯底的頂部,芯片和襯底間的互連是通過引線鍵合實現。
HDI工藝對MEMS封裝來說有很大的優越性。由于相對于引線鍵合來說使用了直接金屬化,芯片互連僅產生很低的寄生電容和電感,工作頻率可達1GHz以上。
HDI還可以擴展到三維封裝,并且焊點可以分布在芯片表面任何位置以及MCM具有可修復的特性。

