文獻標識碼: A
DOI:10.16157/j.issn.0258-7998.2017.01.006
中文引用格式: 李照,張戰國,高博,等. 晶體管場環終端技術的優化設計及應用[J].電子技術應用,2017,43(1):24-27.
英文引用格式: Li Zhao,Zhang Zhanguo,Gao Bo,et al. Optimization design and application of transistor field ring termination technology[J].Application of Electronic Technique,2017,43(1):24-27.
0 引言
雙極型晶體管是半導體器件中最為通用的一種,特別是一些具有高耐壓、大電流等性能的雙極型晶體管在電力電子技術領域獲得越來越廣泛的應用。為了提高晶體管的耐壓,已開發的高壓終端結構有場板技術、刻槽技術、場環技術等,這幾種終端技術都有其各自不同的特點,其中場環技術可由常規工藝實現,且工藝簡單,提高耐壓效果好,是一種常用的改善晶體管耐壓的有效方法。本文主要研究場環終端技術的優化設計及其在實際版圖設計中的應用。
1 浮空場環的工作原理
在擴區主結的四周設置浮空場環是提高擊穿電壓的一個有效方法。浮空場環能夠有效改變主結附近的電場分布,使曲面結的曲率半徑增大,抑制表面電場的集中,從而提高器件的擊穿電壓。圖1所示為同一結構在添加浮空場環前后的耗盡層邊界對比。與未加浮空場環結構相比,主結附近增加了浮空場環的結構其耗盡層邊界也發生了變化,有效增大了結的曲率半徑,從而達到提高擊穿電壓的目的。

2 浮空場環的設計優化
浮空場環的設計重點是確定場環與主結的間距,為了能有效改變主結附近的電場,浮空場環必須設置在主結的耗盡寬度內,如果浮空場環距離主結過近,其電勢會和主結很接近,因為高電場出現在浮空場環處,并不能有效提高擊穿電壓;而如果浮空場環設置得距離主結過遠,其對主結電場的影響會很小,對擊穿電壓的提高也不明顯。所以有必要將浮空場環設置在最佳的間距來提高擊穿電壓。
本文主要針對的是一款高壓NPN晶體管的版圖設計時遇到的問題,該款晶體管采用刻槽工藝來滿足高耐壓要求,但由于刻槽工藝相比場環工藝較難實現,而且需要專業的刻蝕設備,成本也較大。所以選擇用浮空場環技術代替刻槽技術來滿足該款晶體管的高耐壓要求。
在進行浮空場環設計時,場環間距是一個很關鍵的參數。在最優間距時,主結與浮空場環同時達到擊穿臨界電場。在實際設計場環間距時主要考慮的因素包括:(1)場環與主結的最佳間距;(2)基區和場環的橫向擴散。
2.1 場環與主結的最佳間距
根據經驗,場環與主結的最佳間距WS一般在平行平面結擊穿時耗盡層寬度[1]的0.15~0.35倍范圍內。對于本設計,BVCBO需大于600 V,實際設計時考慮到20%的設計余量,BVCBO設計值為720 V。由于本設計CB結是由N型外延與P型基區擴散區形成的PN結,而外延相對于基區摻雜濃度很小,因此該PN結可近似為單邊突變結即該結耗盡區主要在外延這邊,所以用單邊突變結時的耗盡區寬度計算公式進行計算。
一般地,若W為擊穿時的耗盡區寬度,耗盡區寬度的計算公式為:

由于該PN結近似于單邊突變結,該集電區耗盡區寬度可用突變結耗盡層近似,因而該公式可以簡化為:

根據圖2的單浮空場環歸一化最優間距,可以看出歸一化最優間距隨著結歸一化結曲率半徑的增大而增大。最優間距在平行平面結擊穿時耗盡層寬度的0.15~0.35倍范圍內。通過對要設計晶體管樣品的解剖分析及仿真,其基區結深為30 μm左右,通過計算已知擊穿時耗盡層寬度為67 μm,可以得到其歸一化曲率半徑為0.44,則其歸一化最優場環解析值為0.35。所以場環的最優間距WS=67×0.35≈23 μm。
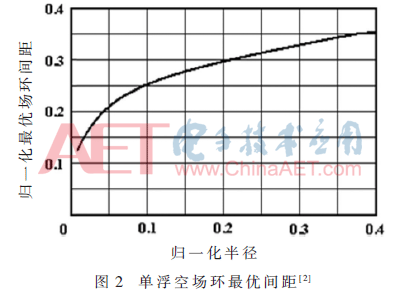
2.2 考慮基區的橫向擴散
由于基區在注入推結時,雜質離子在向縱向擴散的同時還存在橫向擴散,所以在設置場環間距時必須考慮到結的橫向擴散。本設計基區結深Xj=30 μm,根據經驗,雜質離子橫向擴散長度約為其縱向擴散長度的80%,所以基區的橫向擴散長度為0.8Xj。因場環與基區主結是同時形成的,所以兩邊的橫向擴散都需要考慮,這里需考慮的橫向擴散總距離為2×0.8Xj=2×24 μm=48 μm。
綜上所述,該產品版圖設計的場環距基區的主結間距是上述幾個值之和,即:

實際版圖設計[3]時取整70 μm作為場環間距。由式(3)可知,該產品版圖設計時場環的最優間距為70 μm時滿足設計耐壓要求。
3 仿真驗證
為了驗證場環是否能有效提高耐壓,首先用Silvaco軟件對該產品加浮空場環前后的BVCBO(集電極-基極擊穿電壓)、BVCEO(集電極-發射極擊穿電壓)等電特性進行了仿真。隨后,在相同條件下對采用浮空場環技術和刻槽技術的兩種不同結構分別進行仿真,對比其仿真結果。
仿真時,采用電阻率為23 Ω·cm的N型襯底(摻磷雜質濃度為2.1×1014/cm3),基區采用注入劑量為5E15的硼,發射區采用注入劑量為8E17的磷。
對于未加浮空場環的結構,其仿真結果如圖3、圖4所示。

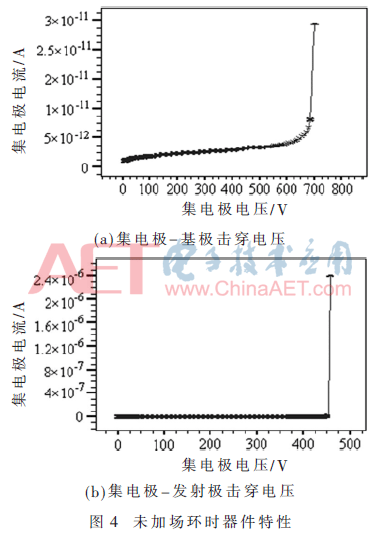
圖3顯示了常規結構的工藝仿真結果及CB結擊穿時的電場分布,從圖3(a)可看出其集電極-基極結擊穿時硅材料內部的電場分布情況,電場線的疏密代表電場的強弱,電場線越密處電場越強;從圖3(b)可看出其縱向結構,基區結深30 μm,發射區結深12 μm。圖4為未加浮空場環時仿真所得的器件特性,由圖4仿真結果可以看出,基區周圍未加浮空場環前,BVCBO不到700 V,BVCEO約為460 V左右。
由圖5仿真結果可以看出,加浮空場環后,BVCBO達到800 V左右,BVCEO為500 V左右。圖6為CB結擊穿時,基區主結與浮空場環的電場分布,電場線越密,代表電場強度越強,從圖6(a)中可以看出,當CB結擊穿時,其電場線最密處出現在基區主結與場環結的拐點處,代表這兩處電場最強,即擊穿點;從圖6(b)中可以看出,當CB結擊穿時,基區主結與浮空場環同時達到擊穿臨界電場。

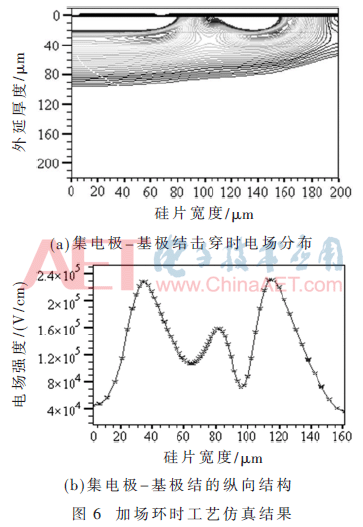
對比上述仿真結果,可看出在相同仿真條件下,加浮空場環的結構與未加浮空場環的結構相比,其結擊穿電壓BVCBO提高了100 V左右,BVCEO提高了40 V左右,擊穿電壓特性在加浮空場環后有明顯提高。因此,場環終端技術確實能夠有效提高器件的耐壓特性。
隨后通過對比解剖國外同類產品,發現其芯片結構采用了刻槽工藝[4]來提高耐壓。仿真時,在其他仿真條件不變的前提下,將浮空場環技術替換為刻槽技術,槽深按實際解剖所得80 μm設計,并對其耐壓特性進行了仿真,其工藝結構及器件特性仿真結果如圖7、圖8所示。
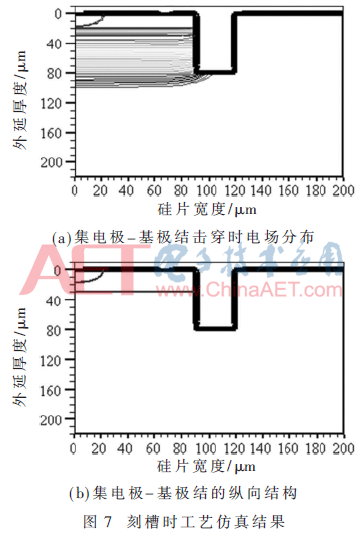
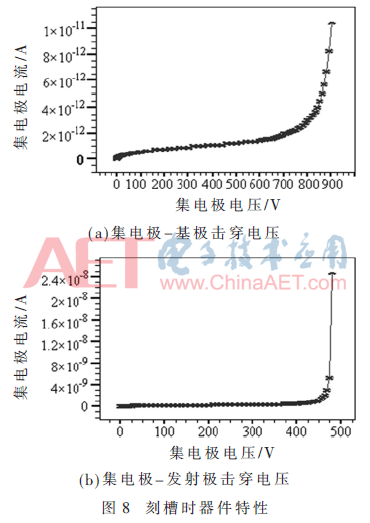
圖7所示為采用刻槽工藝時器件的縱向結構及CB結擊穿時的電場分布,電場線越密,代表電場強度越強,從圖中可以看出電場最強處出現在槽邊緣部位即擊穿點部位。由圖8仿真結果可知,當采用刻槽工藝時,BVCBO和BVCEO也分別能達到 800 V左右和500 V左右。上述3種不同結構器件仿真結果對比如表1所示。

由上述結果可知,采用浮空場環技術與采用刻槽技術的器件特性仿真結果基本一致,這兩種結構相比常規結構都能明顯提高器件的耐壓。但是考慮到刻槽工藝需要專業的設備,而且工藝要求更高,所以在實際芯片生產中可以采用更容易實現且成本較低的浮空場環工藝來替代刻槽工藝,以達到芯片電特性要求。
在對該產品的實際版圖設計時進行了拼版設計,分別采用了兩種不同的技術來提高耐壓,一種是按實際解剖的結果采用刻槽工藝技術,另一種是采用浮空場環技術來提高耐壓。采用拼版設計既可以節約研發成本,用一批實驗流片實現兩種工藝技術的實驗對比,又可以縮短研發時間。通過實際流片測試,其器件電特性都基本滿足設計要求。
4 總結
通過上述的理論分析與仿真結果及實際流片結果,可見浮空場環技術確實有效提高了器件的擊穿電壓。而且與刻槽技術相比,場環技術更容易實現,不需要增加額外工藝步驟,也不需增加專業設備,工藝可行性更高,成本更低。通過理論計算及實驗仿真可實現場環的設計優化,且其在工藝上容易實現,兼容性好。通過本次版圖設計,體會到在以后的分立器件設計中,不一定非要照搬樣品的結構設計,而是應該根據生產線的實際情況選擇成本最低、更容易實現且工藝兼容性更好并能實現相同效果的設計。
參考文獻
[1] 劉恩科,朱秉升.半導體物理學[M].北京:電子工業出版社,2015.
[2] BALIGA B J.功率半導體器件基礎[M].韓鄭生,陸江,宋李梅,譯.北京:電子工業出版社,2013.
[3] HASTINGS A.模擬電路版圖藝術[M].王志功,譯.北京:電子工業出版社,2012.
[4] MAY G S,施敏.半導體制造基礎[M].代永平,譯.北京:人民郵電出版社,2007.
作者信息:
李 照,張戰國,高 博,常正陽,黃山圃
(航天科技集團九院七七一研究所,陜西 西安710000)

